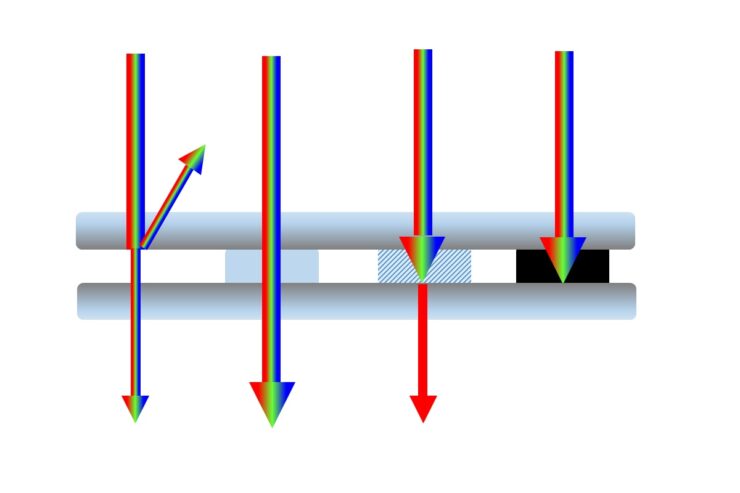
光学機能付与技術
最適な分子構造を選択することで、光の屈折・吸収を制御する技術です。 屈折率、アッベ数、複屈折、波長カット、遮光(OD)、マット、反射、散乱など多様な光学機能の付与が可能です。
協立化学産業の研究開発により産み出される技術や、関連する技術情報をご紹介します。
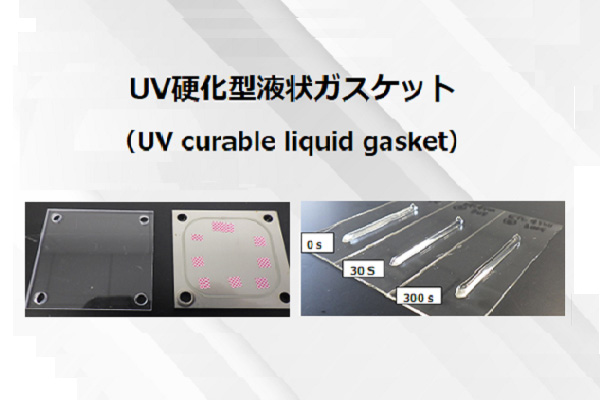
定型ガスケット(ゴム成形品,発砲製品)に代わる液状のUV硬化型ガスケット。 部材へ直接塗布⇒UV硬化が可能なため封止性の高い封止材として使用が可能。
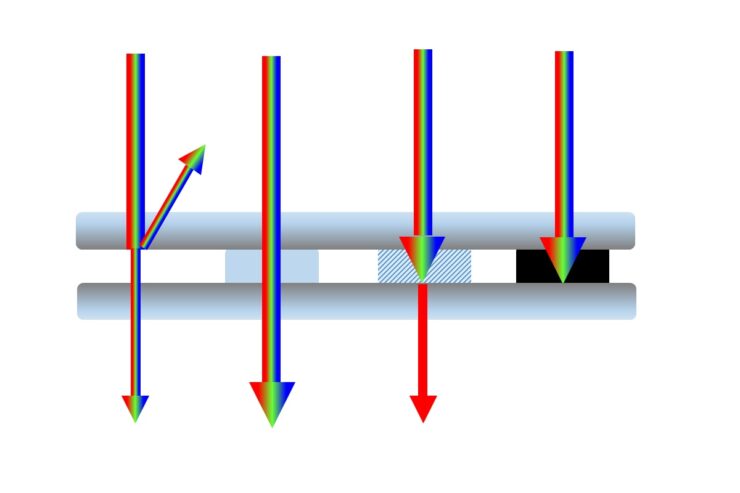
最適な分子構造を選択することで、光の屈折・吸収を制御する技術です。 屈折率、アッベ数、複屈折、波長カット、遮光(OD)、マット、反射、散乱など多様な光学機能の付与が可能です。

無溶剤・低エネルギー硬化・易解体で持続可能な社会を実現する技術です。

厳しい環境下で使用される用途や長期間にわたる使用が見込まれる用途において不可欠な技術です。材料分子設計や配合設計を駆使し、お客さまの提供する製品やサービスの品質向上に貢献します。